 جدید
جدیدطیف سنجی جرمی یون ثانویه (SIMS)
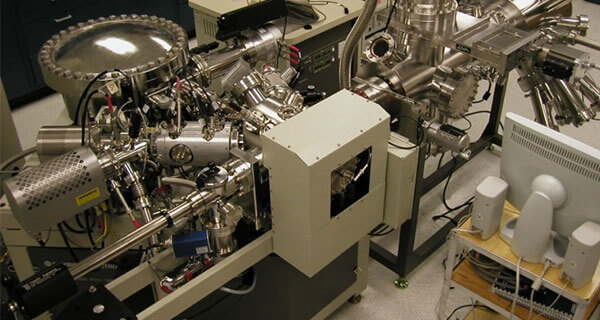
طیف سنجی جرمی یون ثانویه (SIMS) تکنیک تجزیه و تحلیل ترکیب سطوح جامد و لایههای نازک، توسط کندوپاش سطح نمونه با پرتو یون متمرکز اولیه و جمعآوری و تجزیه و تحلیل یونهای خارج ثانویه است. این یون ثانویه همراه با طیفسنج جرمی اندازهگیری میشود و برای تعیین ترکیب عنصری، ایزوتوپی و یا مولکولی سطح کاربرد دارد.
طیف سنجی جرم یون ثانویه یک تکنیک مورد استفاده در علم مواد و بررسی مواد حالت جامد است. سیمس حساسترین تکنیک تجزیه و تحلیل سطح است که قادر به تشخیص عناصر موجود در محدوده یک در میلیارد است. در روش طیفنگاری جرمی یون ثانویه (SIMS) پرتوی از یونهای اولیه که میتواند تا قطر حدود ۲۰ نانومتر متمرکز شود، نمونه را روبش میکند و برای بیرون انداختن یونهای ثانویه از نمونه به کار میرود. جرم یون های ثانویه توسط یک طیفنگار جرمی تعیین میشود.
این تکنیک مخرب است و لایه اتمهای مورد بررسی از نمونه برداشته میشود. در جریانهای پایین از پرتو یونی اولیه، این اتفاق به آهستگی رخ میدهد و این تکنیک به عنوان Static SIMS شناخته میشود. در موارد بهینه، حتی ۱/۰ درصد یک تک لایه از ماده را هم میتوان آشکار کرد. اگر از جریانهای بیشتر پرتو یونی اولیه استفاده شود، ماده با سرعت بیشتری برداشته میشود و هر لایه در حین برداشته شدن آنالیز میشود؛ بنابراین میتوان پروفیل عمقی را به دست آورد. این تکنیک به عنوان Dynamic SIMS شناخته میشود.
پسورد فایل فشرده : www.iran-mavad.com










دیدگاه کاربران
سلام خسته نباشید.دانلود نمیشه.لینک خرابه
درود
لینک دانلود چک شد مشکلی نداره
اگر با گوشی دانلود می کنید توضیحات داخل باکس دانلود رو مطالعه بفرمایید
سلام خسته نباشیددانلود نمیشه لینک دانلود خراب شده
مشکلی نیست تست شد.